
Vertikale Integration von MEMS-Sensoren auf elektrischen Schaltungen

Produkte der Unterhaltungselektronik wie Smartphones, Tablets und Smartwatches sind aus unserem Alltag nicht mehr wegzudenken. Ein wesentlicher Bestandteil dieser Produkte ist das mikro-elektro-mechanische System (MEMS). Während Bauteile, Baugruppen und Geräte in ihren Abmessungen stetig reduziert werden, ist dies für die darin zu integrierenden MEMS-Sensoren aufgrund ihrer Verdrahtung nur begrenzt möglich.

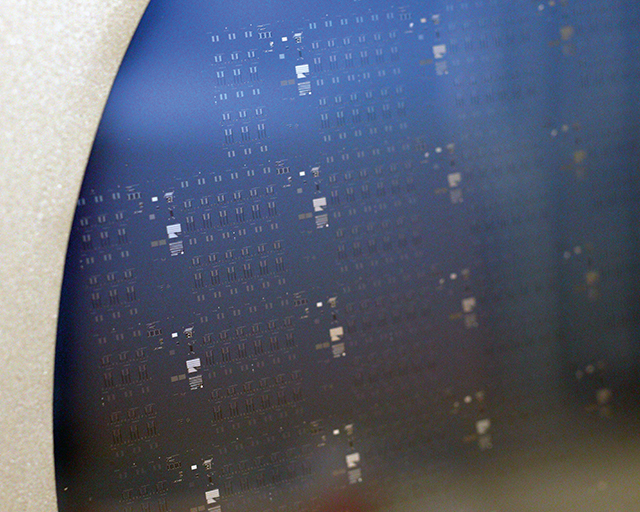
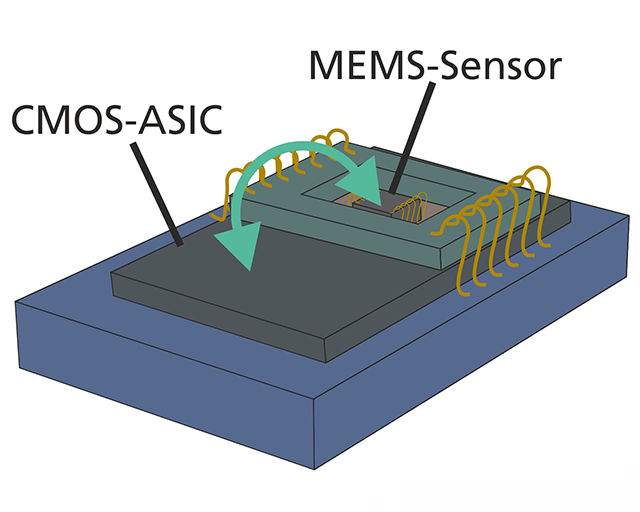
Einen Ansatzpunkt stellt hier die vertikale Integration von MEMS-Sensoren dar. Das Fraunhofer IST hat in einem gemeinsamen Projekt mit den Fraunhofer-Instituten ILT und ISIT einen Abscheidungsprozess für Silizium entwickelt, der die direkte Abscheidung von Silizium auf einem Bauelement mit anwendungsspezifischer integrierter Schaltung (englisch: Application-Specifc Integrated Circuit, ASIC) ermöglicht. Dadurch entfällt die Notwendigkeit einer Verdrahtung zwischen MEMS und der ASIC-Komponente vollständig und erlaubt eine Reduzierung der Baugröße.
Herausforderungen aktueller Lösungen
Mehr als 80 Prozent aller MEMS-Inertialsensoren werden in einem Epitaxieprozess mittels chemischer Gasphasenabscheidung (englisch: Chemical Vapor Deposition, CVD) hergestellt, wobei die Abscheidungstemperaturen über 1000 °C betragen können. Obwohl es Möglichkeiten gibt, die Temperatur zu reduzieren, bestehen erhebliche Einschränkungen. Ein nichtepitaxialer thermischer CVD-Prozess ermöglicht die Reduzierung der Substrattemperaturen auf ~650 °C, jedoch führt dies zu geringen Abscheideraten. Fortschritte bei der plasmaunterstützten CVD (englisch: plasma-enhanced CVD, PECVD) haben ebenfalls deutliche Absenkungen der Substrattemperaturen erreicht, es kommt aber zu einer signifikanten Einbringung von Spannungen in die resultierenden Filme. Diese können dann zu Verformungen der MEMS-Strukturen führen.
Die Hot-Wire-Lösung
Hier zeichnet sich die heißdrahtaktivierte CVD (englisch: Hot-Wire CVD, HWCVD) aus. Durch eine Abscheidung von Silizium bei niedrigen Substrattemperaturen kann bei gleichzeitig hohen Abscheidungsraten eine spannungsarme Siliziumschicht mit großflächiger Gleichmäßigkeit erreicht werden. Außerdem können hohe Filmleitfähigkeiten erreicht werden, indem Prozessparameter derart abgestimmt werden, dass die Kristallinität der Filme erhöht wird.
Die 7-Kammer-Durchlaufanlage am Fraunhofer IST zur Abscheidung von Silizium, Siliziumoxid- und Siliziumnitrid-schichten ermöglicht Beschichtungsflächen von über 600 mm x 500 mm.
Mit der Zielsetzung der direkten MEMS-ASIC-Integration hat das Fraunhofer IST ein neuartiges Silizium-Abscheidungsverfahren mittels HWCVD entwickelt. Dieses Verfahren ermöglicht die Abscheidung dicker (> 10 µm), hochleitfähiger (~0,1 Ωcm), nanokristalliner Siliziumschichten mit dem signifikanten Vorteil von nahezu null (< 10 MPa) Schichtspannungen. Dies wird unter Beibehaltung einer niedrigen Substrattemperatur (< 420°C), hohen Abscheidungsraten (> 1,8 nm/s) und einer sehr guten Skalierbarkeit erreicht. Die Siliziumschichten wurden auf Siliziumwafern mit NMOS-Teststrukturen (N-type metal-oxide-semiconductor) abgeschieden. Aus diesen Schichten wurden am Fraunhofer ISIT MEMS-Strukturen hergestellt.
Die wesentlichen Vorteile der HWCVD-Siliziumabscheidung sind die resultierenden sehr niedrigen Schichtspannungen sowie die Kontrollierbarkeit der Filmkristallinität. Die durchgeführten Arbeiten beleuchten eine industriell relevante Anwendung der HWCVD-Technologie bei der Weiterentwicklung von MEMS/ASIC-Sensorkombinationen. Die vertikale Integration kann dazu beitragen, die Abmessungen elektronischer Geräte weiter zu reduzieren.
Ausblick
Diese Arbeit beschreibt einen wichtigen Fortschritt in der Anwendung der HWCVD-Technologie. Es wurde eine Wissensbasis für Niedertemperaturprozesse geschaffen, die neben der vertikalen MEMS-ASIC-Integration auch neue Möglichkeiten eröffnet, Silizium in MEMS-Qualität auf temperaturempfindlichen Substratmaterialien abzuscheiden.
Dieser Beitrag ist Teil des Jahresberichts 2021.