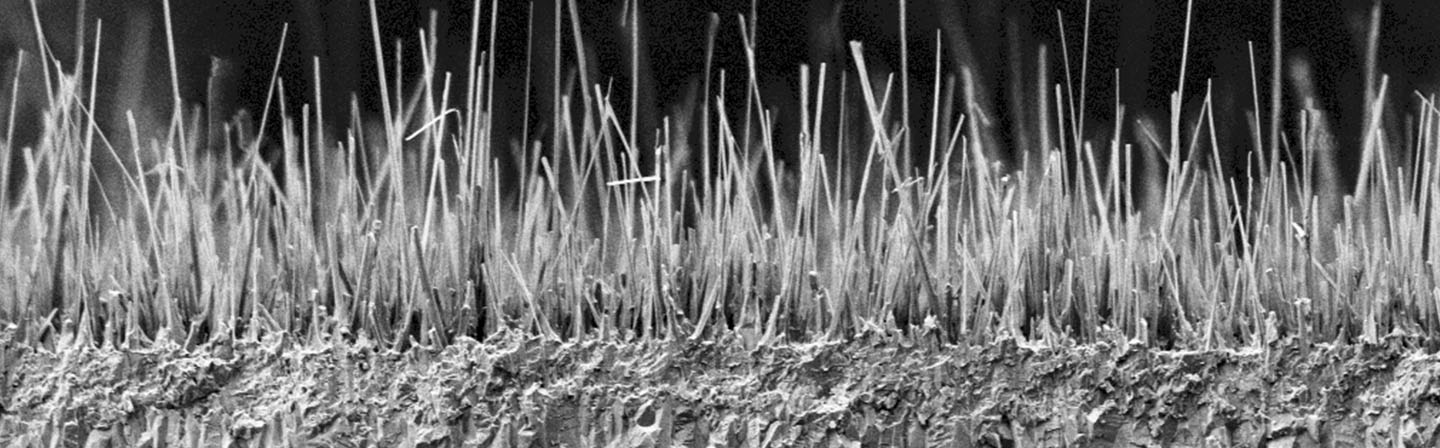
Hochauflösende Oberflächenabbildung mittels Rasterelektronenmikroskopie: REM
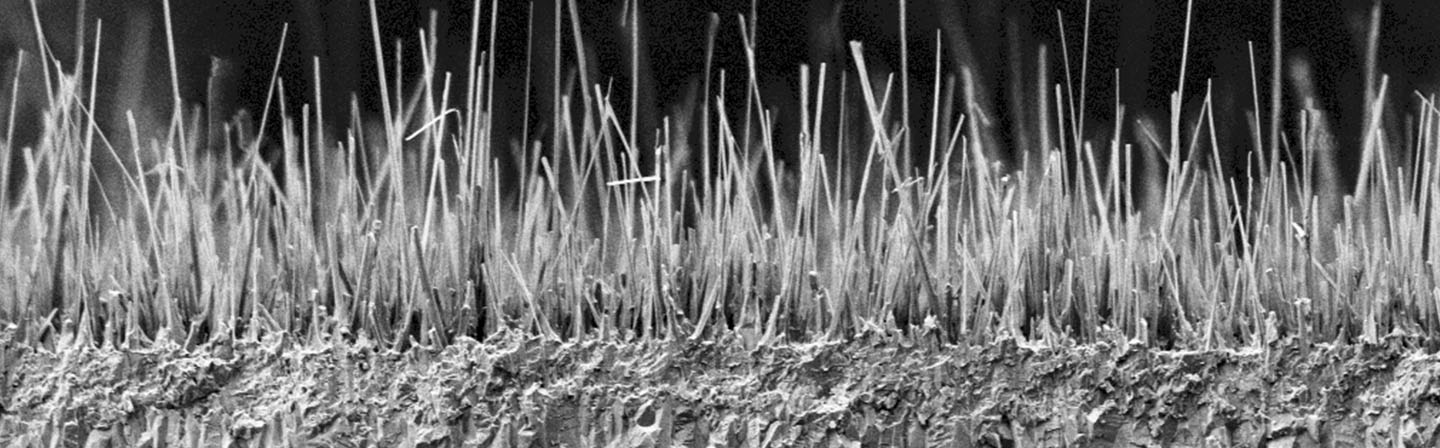
REM-Analyse in der Praxis: REM-Aufnahme einer Bruchkante mit Kupfer-Whiskern.
Rasterelektronenmikroskopie in der Materialanalytik
Die Rasterelektronenmikroskopie (REM) erlaubt die Abbildung von Oberflächen, Bruchflächen oder Querschliffen mit hoher Auflösung (2 - 5 nm) und hoher Tiefenschärfe. Es ist ein vielseitiges Werkzeug, welches es ermöglicht, innerhalb von Sekunden den Vergrößerungsbereich um ein 20 bis 200 000-Faches zu durchfahren, schnell von einer Probe zur nächsten zu wechseln und mittels Bedampfung auch nichtleitfähige Oberflächen abzubilden. In Verbindung mit der Röntgenspektroskopie (EDX) ist die REM-Analyse das ideale Werkzeug zur Schadensanalyse, weil es mikroskopische Visualisierung und chemische Punktanalyse miteinander verbindet.
Spezielle Analysenverfahren am Rasterelektronenmikroskop (REM)
- Präzise Schichtdickenbestimmung im Nanometer- bis Millimeterbereich durch Messung an (Kryo-)Brüchen oder Querschliffen
- Auf Element- oder Topographiekontrast optimierte Abbildung, durch Verwendung verschiedene Detektoren (Inlens, SE, BSE)
- Darstellen des Gefüges von Materialien durch Kontrastoptimierung oder Anätzen der Oberflächen
- Analyse von Mikrodefekten durch Herstellung von lokalen Präzisionsschnitten mittels Focussed Ion Beam (FIB)
- Herstellung von Lamellen zur Transmissionsabbildung der inneren Materialstruktur