
Reduzierung von Partikelbelastung in Beschichtungsprozessen

Bei optischen Beschichtungen wirken sich Partikel als Schichtdefekte auf die Abbildungsqualität, Leistungsverträglichkeit und Langlebigkeit der Optiken aus, insbesondere wenn es sich um Anwendungen im kurzwelligen Spektralbereich bzw. um Laserapplikationen handelt. Die Reduktion von Schichtdefekten in optischen Beschichtungen stellt daher eines der wichtigsten Ziele der modernen Beschichtungstechnologien dar. Im Rahmen des Projekts »EVAPORE« wurden Mechanismen untersucht, die zur Entstehung von Partikeln führen können. Um das Verhalten von Staubteilchen in Beschichtungsprozessen besser nachvollziehen zu können, wurde am Fraunhofer IST bereits eine Software entwickelt, die in der Lage ist, die Bewegung und das Aufladen von Staubteilchen zu simulieren. Diese diente als Grundlage für die nun ebenfalls am Fraunhofer IST entwickelte Simulationssoftware PALADIN – Plasma Lattice Dust Integrator.


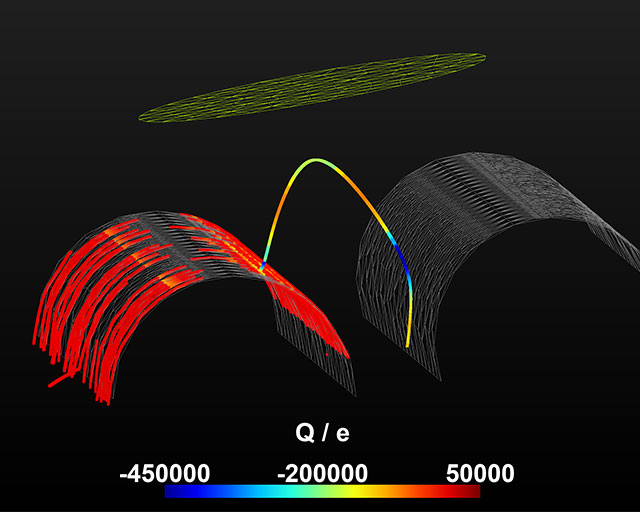
PALADIN – Plasma Lattice Dust Integrator
Die PALADIN-Software ist in der Lage, die Bewegung von Partikeln in einer beliebigen dreidimensionalen Geometrie zu simulieren. Dabei werden gerasterte Resultate aus einer ebenfalls am Fraunhofer IST entwickelten und zuvor durchgeführten Plasmasimulation genutzt, um die Kräfte und Ströme, die auf die Partikel wirken, auf Grundlage eines physikalischen Modells zu berechnen. Weiterhin werden Kollisionen der Teilchen mit bzw. die Haftung in Abhängigkeit von der Geometrie berechnet und aufgezeichnet.
Durch das Simulieren einer großen Anzahl von Teilchen können Statistiken erstellt werden, z. B. über die wirkenden Kräfte oder über die Größenverteilung der Partikel, die am Substrat haften. Außerdem kann die Bahn der Teilchen prinzipiell bis zu ihrem Ursprung rekonstruiert werden, sodass die Herkunft der meisten Teilchen, die eine Oberfläche beeinträchtigen, überprüft werden kann.
Untersuchungen zur Vermeidungsstrategie
Im Rahmen des Projekts wurde eine Vielzahl von Einflussfaktoren hinsichtlich ihrer Auswirkungen auf die Partikelbelastung im Beschichtungsprozess geprüft. Ziel war die Entwicklung von Strategien zur Vermeidung von Partikeln. Dafür wurden verschiedene Prozessparameter wie Prozessdruck, Gasfluss, Entladungsleistung und Pulsfrequenz, aber auch der Einfluss des Targetmaterials und der Herstellungsart experimentell getestet. Die Veränderung des Target-Substrat-Abstands sowie eine Variation des Magnetfelds beim Magnetronsputtern waren ebenfalls Teil der Untersuchungen.
Die Ergebnisse
Als sehr eindeutig hat sich der Zusammenhang zwischen der Häufigkeit des Auftretens sogenannter »Arcs«, d. h. Bogenentladungen, und der Partikelbelastung im Beschichtungsprozess herausgestellt. Solche Arcs entstehen in der Regel in Bereichen, in denen sich isolierende Schichten bilden und eine hohe elektrische Feldstärke vorhanden ist. Darüber hinaus zeigte sich, dass siliziumbasierte Partikel – das Standardmaterial für die niedrigbrechenden Schichten – gegenüber typischen hochbrechenden Materialien wie Tantalpentoxid eine stärkere Partikelbelastung verursachen. Der Grund liegt in der geringeren Masse der Si-Atome gegenüber den anderen Materialien wie z. B. Tantal (Ta) oder Niob (Nb). FIB-REM-Analysen an ausgewählten Proben haben diese Ergebnisse bestätigt. Außerdem wurde beobachtet, dass das Magnetfeld der Kathoden einen Einfluss auf die Bildung von Partikeln zu haben scheint.
Ausblick
Zukünftig sollen weitere Untersuchungen die Datenbasis erhöhen und damit eine bessere statistische Aussagemöglichkeit über die verschiedenen Einflussfaktoren im Beschichtungsprozess hinsichtlich ihrer Relevanz für die Partikelbelastung liefern und ein tieferes Verständnis für die Partikelentstehung ermöglichen. Ziel ist eine kontinuierliche Verbesserung des Beschichtungsprozesses und damit eine Minimierung der Defektdichte.
Das Projekt
»EVAPORE – Entstehungsdetektion und Vermeidungsstrategien von Mikropartikeln in Plasmabeschichtungsprozessen für die optische Industrie« ist ein IGF-Projekt (Fördernummer 18590 N) der Forschungsvereinigung Feinmechanik, Optik und Medizintechnik e. V.
Dieser Beitrag ist Teil des Jahresberichts 2019.